原子間力顕微鏡(AFM)は、1985年にBinnig、QuateおよびGerberによりレンズなどを使用しない非光学系の高解像イメージング技術として発表[1]されました。以来、表面分析における強力な測定ツールとして開発が重ねられてきました。
AFMは精度が高くかつほぼ非破壊測定であり、サンプル表面の形状や、電気的、磁気的、化学的、光学的、機械的特性などを、大気中、液中、超高真空の環境下で高解像度[2]で取得します。
ユニークな機能を併せ持つAFMは、現在、世界中の最先端科学技術の研究機関にとって必要不可欠なものとなっています。
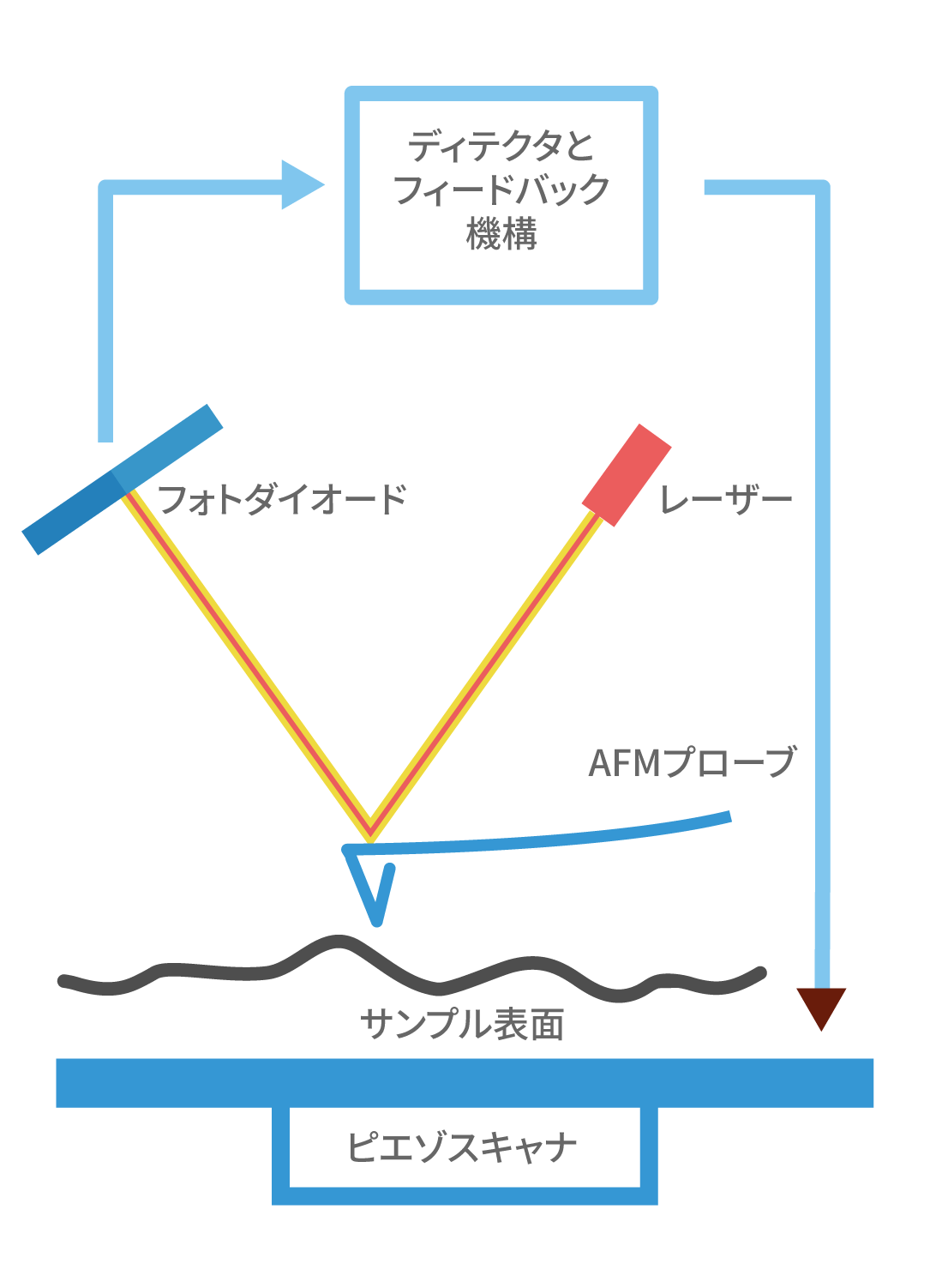
AFMシステムの基本動作原理[3]を図1に示します。サンプル表面上を先端の鋭い探針をもったプローブで走査を行います。一般にAFMにはフィードバックループ機構が備えられています。
通常、探針とこれを支持するカンチレバーは、シリコンまたは窒化シリコンで一体形成されており、柔軟なカンチレバーの先端近くに探針を配置しています。
圧電素子のスキャナが、サンプル表面に対するプローブの水平方向の位置と垂直方向の位置を制御してスキャンを行います。探針がサンプル表面をスキャンするとサンプルの凹凸応じてカンチレバーにたわみが生じます。AFMカンチレバー背面からレーザービームを導入してその反射光をフォトディテクタでとらえることで、このたわみ量を読み取ります。
読み取ったたわみ量を元に、フィードバックループがAFMカンチレバーのたわみをほぼ一定に維持するように、Zスキャナの伸張量を制御。AFM探針とサンプルの間の力も一定に維持されます。
この時のスキャナの伸張量を表面凹凸情報として取得して、コンピューターで表面の3次元の形状を再構成します。
原子間力顕微鏡には2つの基本的な表面形状イメージングモードがあります。コンタクト(静的)モードと、ダイナミック(動的)モードです。
ダイナミックモードは、AFM探針とサンプル表面間の相互作用力に応じて、タッピングまたはインターミッテントコンタクト(間欠接触)モードと、ノンコンタクトモードにさらに細分化されます。
1. コンタクトモードでは、AFMプローブの探針は、サンプル表面と一定の接触を維持しながらサンプルを走査します。(図2)
フィードバックシステムにより、AFMカンチレバーのたわみが一定に維持され、その結果、AFM探針サンプル間の力も一定に保たれます。AFM探針とサンプル表面は押し付けられている形になります(図3)ので、AFM探針の摩耗とサンプル表面のダメージを最小限に抑え、分解能を高めるため、通常ばね定数1N/ m以下の柔らかいカンチレバーが使用されます。


コンタクトモードの欠点として挙げられるのが、大気下でほぼ存在する表面のコンタミ層の影響です。柔らかいカンチレバーに取付けられたAFM探針は、この層が原因で横方向に力を受けたり、吸着してしまう場合があります。 これらは、イメージ画像に歪みが生じさせ、さらには横方向の力は探針や柔らかいサンプルにダメージを与える可能性があります。
2. タッピングモードでは、圧電素子でAFMカンチレバーを励振します。励振はプローブの共振周波またはそれに近い周波数(通常数十から数百kHz)で行います。AFMプローブは、AFM探針の先端がサンプル表面にわずかに接触し、カンチレバー振幅が減衰する位置に下され(図4)スキャンを行います。フィードバックシステムは、AFMカンチレバーの振幅減衰を一定に維持するように働き、その結果、相互作用力も一定に保たれます。(図3)

標準的なタッピングモードでは、ばね定数のレンジが10-100N / m、共振周波数が190kHz以上の硬いAFMカンチレバーを使用します。 硬いAFMカンチレバーを使用することにより、大気中の測定でも探針がサンプル表面に吸着してしまうことはありません。また生細胞のような柔らかいサンプルにはばね定数10N/m以下のAFMカンチレバーを使用し、測定によっては0.1N/m以下の柔らかいAFMカンチレバーが使用されます。
ばね定数 >10N/m、f≥190kHzの標準タッピングモード用AFMプローブ
ばね定数 <10N/m、f<190kHzのソフトタッピングモード用AFMプローブ
3. ノンコンタクトモードでは、AFMカンチレバーを、タッピングモードよりも小さい振幅(1nmまたはそれ以下)で振動させ、AFMプローブの探針は引力の働く領域内[4](図3)サンプル表面から数nm~数十nmの位置で維持されます。 タッピングモードと同じく、たわみが一定になるようにフィードバック制御しますが、測定によっては、AFMカンチレバーの振動周波数を一定に維持するようにフィードバックを行うことで一定の相互作用力を維持する(FM-AFM)場合もあります。この制御方式を行うことで、より正確なフォース制御と液中においても超高解像度で測定することができます。

図5:ノンコンタクトモード動作模式図
ノンコンタクトモードの利点は、AFM探針先端の鋭さを維持し、高解像度で表面情報を取得できる点です。 欠点はAFM探針先端とサンプル表面の距離が近い場合は、より高い精度のフィードバック制御が必要となる点です。
ばね定数が高く、共振周波数が高いAFMカンチレバーは、ノンコンタクトモードに最適です。
ばね定数> 25N/m、≥190kHzのノンコンタクトモード用AFMプローブ
サンプルの表面形状のほかに、原子間力顕微鏡は様々な表面情報を取得することができます。これらのイメージングテクニックはすでに紹介した3つの基本的な測定モードのいずれかをベースにしたものです。これらのテクニックを使うことで、形状に加え、凹凸とは異なる表面情報を抽出することができます。
EFM やMFMなどの測定モードでは、リフトモード、ホバーモードといったTwo-Passモードなどの二次的な測定を行います。リフトモードにおいては、通常の形状スキャンとその他の表面情報の取得を独立に行います。一次スキャンでは、通常の形状測定を行います。二次スキャンでは、取得した表面形状情報をもとに指定した距離、通常5-50nm表面から離れた高さでスキャンを行い、AFMカンチレバーの共振周波数シフトや位相シフトを元に、電気的、磁気的なロングレンジの相互間力を測定します。
後に開発されたシングルパス法 では、ロックインアンプを用いることで形状情報とその他の情報を、一度のスキャンで取得することができます。測定感度、分解能の点でも向上しました。
一般的に使用されている様々な測定モードを以下でご紹介します。
1. 位相イメージング: ダイナミックモードの測定モードです。AFMカンチレバー励振のためのドライブシグナルと、検出されるAFMカンチレバー振動の位相ずれを記録することで、サンプルの粘弾性などの表面物性を知ることができます。
硬い材料の位相イメージングのためのAFMプローブ C>25N/m
柔らかい材料の位相イメージングのためのAFMプローブ C<25N/m
2. 液中AFM: コンタクトモードやタッピングモードを使って、生体分子や細胞などのバイオサンプルを液中環境で測定します。液中測定においては、通常窒化シリコン製AFMプローブが使用されます。AFM探針でサンプルにダメージを与えないように、柔らかいばね定数のAFMカンチレバーを選択します。
液中のタッピングモード測定には金コートで f>50kHz を選択します
液中で測定を行う場合は金コートが一般的です
3. 高速AFM (HSS-AFM): メガヘルツの共振周波数を備えたAFMカンチレバーと高速処理が可能な制御装置を組み合わせて実現した測定モードです。スキャン速度とフィードバック速度をビデオレートまで上げることで、バイオサンプルなどの動的プロセスを視覚化できます。
4. 超高真空 (UHV) AFM: 超高真空下でAFM測定を行うことで、水分層やコンタミの影響を抑えながら高分解能イメージングが可能になります。
5. フォースモジュレーション (FM): コンタクトモードでスキャンしている間、周期的な信号をスキャナに印加してAFMカンチレバーを垂直方向に機械的に駆動させます[5]。 カンチレバーの応答振幅はサンプルの弾性特性に依存しているので、サンプルの弾性応答をマッピングできます。
フォースモジュレーションAFMプローブ 通常 C=2-3N/m 、f=60-90kHz
6. 水平力顕微鏡 (LFM): ディテクタに4分割フォトダイオードを使用しているAFMでコンタクトモードスキャンを行うと、AFMカンチレバーの垂直方向のたわみだけでなく水平方向のねじれも検出できます。このねじれはAFM探針に加わる水平力(通常はフリクション)に換算できます。
水平力顕微鏡用AFMプローブ C<0.5N/m ねじればね定数 Ctor<15N/m
7. 電気力顕微鏡 (EFM): 適切なばね定数の導電性AFMプローブに電圧バイアスを印加してノンコンタクトモード測定を行うと、サンプル表面の電界勾配の変化を分析できます。
導電性膜コートの電気力顕微鏡用プローブ 通常 C=2-7N/m、f=60-110kHz
8. ケルビンプローブ顕微鏡 (KPFM): 直流あるいは交流のバイアスをかけて測定することで接触電位や仕事関数のマッピングが可能になります。
導電性膜コートのケルビンプローブフォース顕微鏡用AFMプローブ 通常 C=2-7N/m、f=60-110kHz
9. 走査キャパシタンス顕微鏡 (SCM): 導電性AFMプローブと、高周波の共振回路を利用した静電容量センサーを使用して、局所的な静電容量測定を実行できます。通常は半導体のキャリア濃度の測定に利用されています。この手法はコンタクトモードから派生した測定モードで、DCと高周波ACバイアス電圧を印加し、AFM探針とサンプル表面の間の静電容量の変化を測定します。
導電性膜コートの走査キャパシタンス顕微鏡用AFMプローブ C<10N/m 、 f<110kHz
10. ピエゾレスポンス (PFM): このモードでは、導電性AFMプローブに交流電圧バイアスを印加しながらコンタクトモードスキャンします。逆圧電効果を利用して、表面ドメインの機械的変形を誘発することにより、圧電材料や強誘電材料を調べます。
導電性膜コートのピエゾレスポンスモード用AFMプローブ C<10N/m、f<110kHz
11. コンダクティブAFM(C-AFM): 導電性AFMプローブをコンタクトモードで使用し、局所的なサンプル表面近傍の電気抵抗を測定する手法です。サンプルとプローブの間に電位を与え、電流値を検出します。拡散抵抗顕微鏡(SSRM) は断面を作成した半導体のドーパント濃度を評価するために使われる技術です。どちらの手法もAFM探針には非常に厳しい性能が要求されものであり、高い耐摩耗特性の導電性膜コーティングを施したAFMプローブが必要となります。I-Vスペクトロスコピーは、サンプルの関心領域でポイントコンタクト(定点接触)し電圧バイアスをランプ印加することでバイアスに依存する抵抗率を調べるモードです。
ダイヤモンドまたは白金シリサイド(PtSi)コートのコンダクティブAFMプローブ C<7N/m
12. 磁気力顕微鏡(MFM): AFMプローブに磁性膜をコーティングしてノンコンタクトモードでスキャンをすることで、サンプル表面近傍の磁界を捉えることができます。
磁気力顕微鏡 AFM プローブには磁性膜がコーティングされています。通常 C=2-7N/m、 f=70-75kHz
13. フォースディスタンス測定 (F vs d):この技術は、AFM探針をサンプルに接近、押し付け、表面から離す過程における、AFMカンチレバーのたわみをモニタします。たわみ量はピエゾ変位の関数として記録され、得られた力-距離曲線から接触点における材料の粘弾性、ファンデルワールス力、凝着力、分子アンフォールディングの力などを計算できます。
また、インデンデーション(押し込み)を行い、そのカーブを解析することで弾性率測定にも利用されています。関連技術であるフォースボリュームモードは、1スキャンの間に予め定義された複数の測定ポイントでフォースディスタンス測定を行います。高いフォース感度とカンチレバーがサンプルに加える最大力はトレードオフの関係にあります。測定対象の剛性、測定したい感度や押し込み力に応じて、オペレーターは異なるスティフネスのAFMカンチレバーを選択します。
バイオ、ポリマー試料向けのソフトフォースディスタンス測定用AFMプローブ C<1N/m
耐摩耗ダイヤモンドまたはダイヤモンドライクカーボンコートのナノインデンデーション用AFMプローブ
球状の探針表面形状を定義できるナノインデンデーション用スフィアAFMプローブ
14. パルスフォースモード (PFM): カンチレバーの共振周波数よりも低い周波数でカンチレバーを振動させることにより、探針のコンタクトサイクルすべてのコンタクトポイントで力-距離曲線を取得してサンプルの凝着性や弾性に関するイメージをマッピングします。これを拡張した技術に、化学力顕微鏡(CFM)があり、化学修飾された探針を使用して、サンプル表面のさまざまな化学基の分布に関する情報を取得します。
バイオ、ポリマーサンプル向けソフトパルスフォースモードAFMプローブ C<1N/m
高硬度サンプル向けの高ばね定数パルスフォースモード用AFMプローブ
球状の探針表面形状を定義できるナノインデンデーション用スフィアAFMプローブ
15. ScanAsyst®:は PeakForce Tapping™ をベースに作られた自動イメージングの技術です。BrukerAFMシステムに搭載されており、オペレーターの経験値によらず優れたクオリティのイメージを取得することができます。
ブルカー社製AFMプローブ(ScanAsystおよびPeakForce Tapping)互換品
16. ナノリソグラフィー: ナノリソグラフィー:AFMプローブ探針(スクラッチリソグラフィ)でサンプルに十分に強い力を加えたり、チタンやシリコンなどの特定の基板を局所的に酸化したり、削ったりすることで、サンプル表面を加工できます。AFM探針は、事前に指定されたパスに沿ってサンプル表面を移動し、さまざまな形状の構造を作成できます。
耐摩耗ダイヤモンドまたはダイヤモンドライクカーボンコートのナノリソグラフィー用AFMプローブ
17. コンタクトレゾナンス顕微鏡:ピエゾアクチュエータを使いサンプルに振動を加え、コンタクトモードでサンプル表面をスキャンします。この時のAFMプローブの共振周波数を測定することにより、材料の局所的な弾性を調べることができます。 試料の硬さに応じて剛性の異なるAFMプローブを使用します。
コンタクトレゾナンスAFMプローブの詳細はこちらです。通常、 M=1-10GPaのサ ンプルの場合は C=2-3N/m 、M=10-50GPa のサンプルの場合は C 15N/mまでのAFMプ ローブを使用します
コンタクトレゾナンスAFMプローブ M>50GPaのサンプルの場合 C>40N/m
18. 走査サーマル顕微鏡 (SThM): 熱電対や温度により抵抗が変わる抵抗素子を備えたAFMプローブを使用すると、サンプル表面の局所的な温度や熱伝導率測定が可能になります。
19. 近接場光学顕微鏡 (NSOM, SNOM): 微小な光源を作るAFMプローブを使うことで、回折限界を超える解像度の可視光でのイメージングが実現されます。 NSOMは、金属コーティングされた探針や、光ファイバーを加工したAFMプローブを使用するアパーチャ(開口)モードや、コーティングがされていない鋭い探針を使用したアパーチャレスモードで実行されます。後者は散乱タイプSNOM(s-SNOM)とも呼ばれます
20. ティップエンハンスラマン (TERS) もしくは ナノラマン顕微鏡: ラマン効果は化学的な特性を取得するために使用されます。TERSにより、回折限界を超えるラマン測定を実現し、高分解能ケミカルイメージングが可能になります。TERSでは、単一波長光と、金属コーティングされたAFM探針をナノメートルサイズの光アンテナとして使用し、後方散乱光を収集することによりこれを実現しています。
21. AFM (フォトサーマル) 赤外ナノスペクトロスコピー(AFM-IR): AFM探針近傍の熱膨張から、赤外光の吸収を計測します。
22. Electrochemical AFM (EC-AFM): このモードは、AFMを電気化学測定と組み合わせます。AFM探針を使用して、固液界面(電解液に浸された導電性の表面)での電気化学反応をその場でとらえることができます。3電極タイプの電気化学セルにおける電極の役目を果たす金属ワイヤーを備えた、AFM専用の電気化学セルを使用します。
23. Scanning Tunneling Microscopy (STM): 電気的にバイアスされた導電性AFM探針を、サンプル表面からサブnmの高さでスキャンをします。導電性のサンプルとAFM探針先端の間のトンネル電流をモニタすることにより、表面情報を取得します。Zフィードバックをオフにし、横方向の位置の関数としてのトンネル電流を記録する高さ一定モード、またはZフィードバックをオンにしてトンネル電流が一定に維持される定電流モードがあります。 STMは、横方向に0.1 nm、縦方向に0.01 nmという非常に高い解像度を実現します。
厳密に言えば、STMはプローブとフィードバックのセットアップがAFMとは異なるため、STMとAFMは別の顕微鏡です。ですが、STMとAFMはどちらも、走査型プローブ顕微鏡(SPM)と呼ばれる技術で構成されています。 1981年にGerd BinnigとHeinrich Rohrerによって開発されたこのSTMはAFMの直接の前身であり、STMは現在においても非常に重要かつ優れた顕微手法です。
ここで挙げた測定モードがすべてではありません。ほかにも多くの測定モードがあります:
Torsional Resonance Mode
Scanning Microwave Impedance Microscopy (SMIM)
Scanning Electrochemical Potential Microscopy (SECPM)
Critical Dimension AFM (CD-AFM)
TUNA AFM
Atomic Force Profiling (AFP)
Photoconductive AFM (pcAFM)
PeakForce Tapping
PeakForce TUNA
PeakForce Quantitative Nanomechanical Property Mapping
Three-Dimensional Sidewall Imaging (3D-AFM)
Deep Trench AFM
Scanning Ion Conductance Microscopy (SICM)
等々…
サンプル表面を詳細に知るには、より高い分解能でAFMイメージを取得する必要があります。
垂直方法 (Z-axis) の分解能はAFMプローブ形状にはほとんど依存しません。一方で、水平方向の分解能は通常、顕微鏡自体の性能だけでなく、AFM探針の形状に依存する場合が多くあります。ミドルクラス以上のAFMであれば、サブnmの水平方向分解能とサブオングストロームの垂直方向分解能を実現できる機能を持つ機種があります。 NanoAndMoreが提供する高品質のAFMプローブは、先端曲率半径が10 nmを下回りますので原理上は数nmの分解能を得られます。 先端曲率半径が1〜5 nmの高分解能AFMプローブは、原子レベルで平坦な表面であれば原子または原子分解能に近い解像度を達成することも可能です。 当然のことながら、AFM探針の摩耗とコンタミを抑える最適な条件でスキャンし、探針本来の鋭さが維持されている場合にのみ高解像イメージを取得できます。
1. G. Binnig, C. F. Quate, Ch. Gerber, Atomic Force Microscope. Phys. Rev. Lett. 56, 930–933 (1986). doi:10.1103/PhysRevLett.56.930 https://journals.aps.org/prl/pdf/10.1103/PhysRevLett.56.930
2. O. Marti, B. Drake, P. K. Hansma, Atomic Force Microscopy of Liquid-Covered Surfaces: Atomic Resolution Images. Appl. Phys. Lett. 51, 484 (1987). doi:10.1063/1.98374
3. O. Marti, AFM Instrumentation and Tips. In: Handbook of Micro/Nanotribology, 2nd edn., ed. by B. Bushan (CRC, Boca Raton 1999), pp. 81–144
4. T. R. Albrecht, P. Grütter, D. Horne, D. Rugar, Frequency modulation detection using high-Q cantilevers for enhanced force microscope sensitivity". Journal of Applied Physics. 69 (2): 668 (1991). doi:10.1063/1.347347
5. P. Maivald, H. J. Butt, S. A. C. Gould, C. B. Prater, B. Drake, J. A. Gurley, V. B. Elings, P. K. Hansma, Using force modulation to image surface elasticities with the AFM. Nanotechnology. 2:103-106 (1991). doi:10.1088/0957-4484/2/2/004
