コンダクティブ AFM プローブ
当初、開発された最初の走査型プローブ技術は、導電性プローブを使用していました。走査型トンネル顕微鏡(STM)は、タングステンワイヤなどで作られたSTM探針と表面の間のトンネル電流を制御しサンプル表面全体を走査します。原子分解能でサンプル表面を画像化する技術で、1986年にノーベル物理学賞を受賞しました。原理上の大きな制限は、走査型トンネル顕微鏡が導電性表面のみに限定されていたことです。
STMはの用途の一つは、サンプルの表面形状を取得することです。導電性サンプルの表面という限定を取り払うために、走査型または原子間力顕微鏡(AFM)が開発されました。 その後、AFMのオプションとして多くの特性評価方法が開発され、表面の電気的特性にも焦点が当てられました。
標準のAFMプローブ材料は導電性ではないため(絶縁性であるか、絶縁表面酸化物層を迅速に形成します)、AFM探針とAFMカンチレバーは、電流が流れるように導電性材料でコーティングする必要があります。
原子間力顕微鏡の短い歴史の中で、半導体およびMEMS製造技術で利用可能なほぼすべての金属や合金がAFMプローブに使われました。金属は良好な導電性を有し、加工が容易で比較的安価です。ただし、現在ではその一部の材料のみが普及し、導電性AFMプローブに使用されています。当初は磁気力顕微鏡用に使用されていたコバルトクロムや、貴金属である白金が導電膜として使われています。これらは絶縁層となりうる酸化膜を形成しないからです。
白金薄膜層の硬度を上げるために、少量の(より硬い)イリジウムが添加されます。したがって、通常、すべての白金コーティングされたAFMプローブは、95%のプラチナと5%のイリジウムで構成され、多くの場合PtIrと呼ばれます。金は、AFMカンチレバーの分子修飾を簡単に行うために一般的に使用されており、生体分子をAFM探針に取り付けることができます。
プラチナと同様に、金は酸化物を形成しない貴金属ですが、プラチナよりも非常に柔らかく、白金よりも摩耗しやすくなります。一般に、すべての金属コーティングは、AFM探針の摩耗効果のため、コンタクトモードAFMでの長時間の使用には適していません。金属コーティングは通常、静電力顕微鏡法やケルビンプローブフォース顕微鏡法などのリフトモードAFM技術に使用する必要があります。
比較的柔らかい金属コーティングの摩耗問題を克服するために、より耐性のある他のコーティングも使用されています。非常に硬いダイヤモンドコーティングはその一つですが、AFMプローブをコーティングするにはある程度の厚さが必要となり、通常100nm程度の先端曲率半径になります。また、ダイヤモンドの導電率は金属に比べて約10分の1です。導電率、硬度、解像度の点でバランスを取るのであれば、白金シリサイドAFMプローブも選択肢になります。
導電性AFMプローブを使用するAFMアプリケーションは、主に2つの分野に分けられます。1つは、AFMプローブを表面に接触させ電流を測定する方法、そしてもう一つが、リフトモードを使った電位測定です。コンダクティブAFM(c-AFM)はコンタクトモードで実行されます。基本的に、導電性コーティングされたAFMプローブをサンプル表面と接触させて、バイアス電圧をAFM探針とサンプルの間に印加します。測定された電流は、スキャンされた領域の電気的特性に関する情報を提供します。この方法では、ユーザーにより定義された力がAFM探針に加わりますので、この用途に使用される導電性コーティングは、耐摩耗性が要求されます。
走査型静電容量顕微鏡(SCM)は、半導体サンプルのキャリア濃度をマッピングするために使用されます。原理は、導電性AFM探針をコンデンサの「金属」部分と使用して局所的に金属-酸化物-半導体(MOS)コンデンサ構造を形成してサンプルの評価を行います。DC電圧とAC電圧を重畳印加することにより、ドープタイプとドープ量を分析できます。通常、中程度のばね定数のAFMカンチレバーが使用されます。これは、安定したコンタクトフォースを確保し一定の接触面積を確保するためです。ダイヤモンドやプラチナシリサイドなどの耐摩耗性コーティングは、様々なタイプのAFMカンチレバーのSCMアプリケーションに使用されます。走査型静電容量顕微鏡法には、CDT-CONTRまたはPtSi-CONT、CDT-FMRまたはPtSi-FM、CDT-NCHRまたはPtSi-NCH、およびAll-In-One-DDAFMプローブをお勧めします。
導電性AFM(c-AFM)、トンネリングAFM(TUNA)、I-Vスペクトロスコピー:バイアス電圧をAFM探針もしくはサンプルに印加することで、局所的な導電率またはその変化を観察できます。 c-AFMとTUNAの原理は同じであり、c-AFMがより一般的なモードで、一方TUNAは絶縁層の特性評価に使用されています。 c-AFMでは通常、ある狭い範囲の電流しか観察できませんが、TUNA電流の範囲は、非常に低いトンネリング電流から絶縁層破壊電流まで幅広く観察可能です。さらに、絶縁層の特性評価はさまざまな方法で実行できます。探針をあるポイントに停止させた状態で一定のバイアス電圧を印加するほか、印加電圧を上昇させることによっても評価を行います。この手法はI-V-Spectroscopyと呼ばれます。繰り返しになりますが、c-AFMおよびTUNAアプリケーションでは、サンプルに応じて、適切なAFMカンチレバーにドープされたダイヤモンドやプラチナシリサイドなどの耐摩耗性に優れた導電膜コーティングをしたプローブが選択されます。
走査拡散抵抗モード(SSRM):半導体におけるドーパントやp-n接合の位置に関する情報を取得する2つ目の方法はSSRMです。マクロスコピックな手法では、ある半径の先端を持つニードル2本をある間隔で自然酸化物を通して半導体に押しつけます。定義された電圧を印加し電流が測定されます。通常、サンプル表面は非常に浅い角度で面出ししているため、高い空間分解能が得られます。一方、SSRMでは、AFM探針の先端曲率半径が小さいため、サンプルの準備(面出し)は必要ありません。走査拡散抵抗モードは、サンプルの断面に対して実行されます。酸化層を貫通するには、非常に高いばね定数を持つAFMカンチレバーが必要です。ダイヤモンド導電性コーティングだけがSSRMの高い力に耐えることができます。通常、SSRMにはCDT-NCHR、DDESP、またはAll-In-One-DDが使用されます。
サンプルと接触して実行されるc-AFMアプリケーションとは対照的に、いわゆるリフトモード技術では、最初のラインスキャンで表面形状を記録し、その後のリトレースでサンプルから離れた位置におけるサンプルの電荷とAFMプローブの電荷による相互間力を記録します。これらのアプリケーションでは、中程度のばね定数のAFMカンチレバーが使用されます。これはACモードまたはタッピングモードでの正確な形状測定と、AFMチップとサンプル間の電界の変化検出を両立できるばね定数です。これらの測定モードの摩耗は比較的小さいため、ここでは白金またはプラチナシリサイドなどの導電性の高い材料をコーティングとして使用します。
電気力顕微鏡(EFM)はトレーススキャンでACまたはタッピングモードを使い表面形状を取得した後、AFM探針を規定した高さ引き上げリトレースします。バイアスされた導電性AFMプローブの電荷とサンプルの電荷が、静電気力として相互作用します。電荷分布が変化すると、電気力の勾配が変化し、AFMカンチレバーが曲がります。これをディフレクションレーザーで検出します。ケルビンプローブフォース顕微鏡(KPFM)は、KPFMはEFMと同様の動作を行い、サンプルの仕事関数に関する情報を取得します。探針に交流電圧とオフセット電圧を印加し、カンチレバーの共振周波数の変調成分がゼロとなるように探針側のオフセット電圧を制御しながらスキャンを行います。すべてのリフトモード技術、静電力顕微鏡法、およびケルビンプローブフォース顕微鏡法では、中程度のばね定数のソフトタッピングまたはフォースモジュレーションAFMカンチレバーにプラチナまたはプラチナシリサイドなど低抵抗率材料をコーティングしたAFMプローブが推奨されます(PtSi-FM、PPP- EFM、EFM、ElectriMulti 75)。
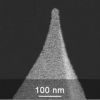

AFMティップ形状: 反転


AFMティップ形状: 反転


AFMティップ形状: various







